解析先進製程:EELS解碼化學鍵結之謎
![]() 2025.3.26
2025.3.26
 活動內容
活動內容
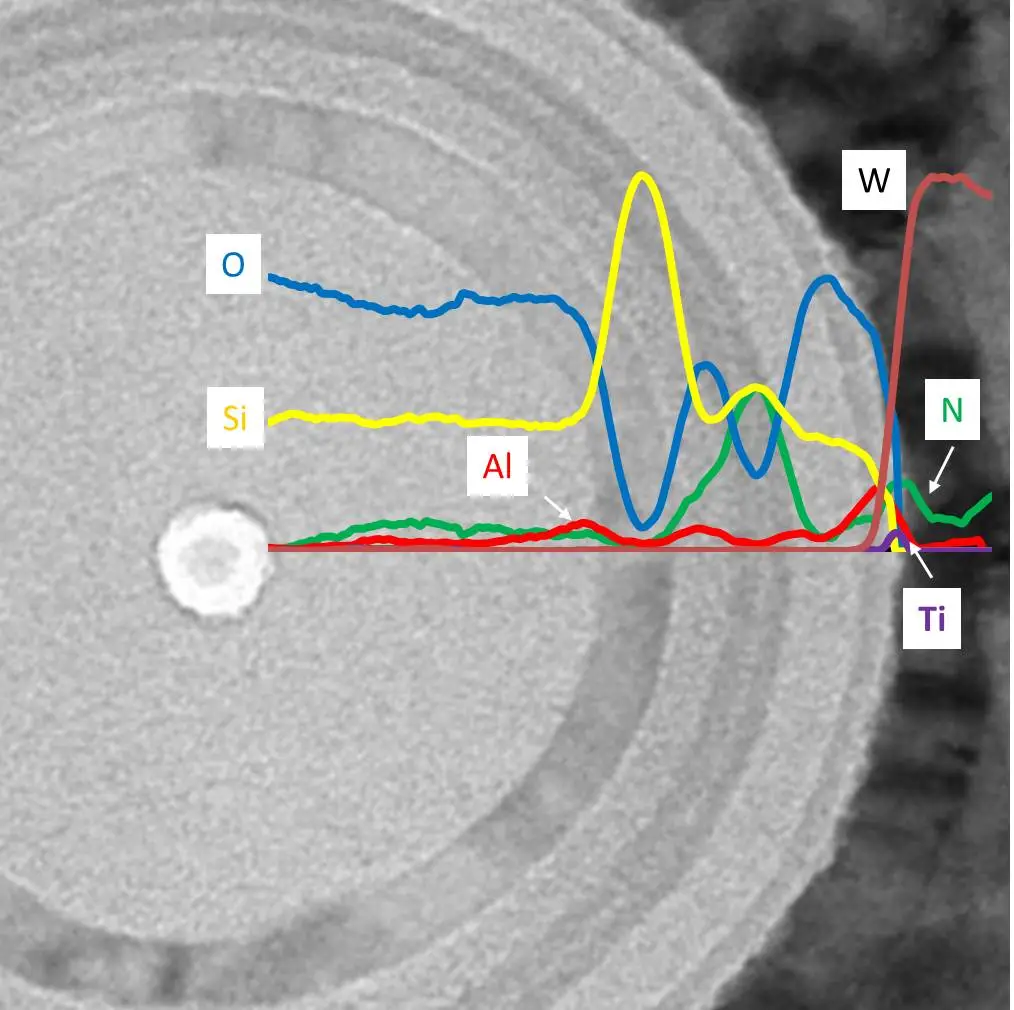
先進製程的發展是半導體產業的核心驅動力,但在過去二十年中,我們明顯看到,受摩爾定律啟發的尺寸縮小不再是預測邏輯製程技術節點演變的唯一指標。逐漸地,半導體產業開始採用其他技術創新,如結構創新、材料突破與系統級整合,並以「性能(P)-功耗(P)-面積(A)-成本(C)」四大評估指標來取代單純以微影為中心的尺寸縮小。
在結構創新方面,為了解決平面電晶體架構的短通道效應而引入的22nm/16nm節點FinFET電晶體架構,即將在2024/2025年停止演進,取而代之的是能進一步提升閘極控制能力的GAAFET架構,預計未來在1nm節點以下(埃米),電晶體架構將演變為垂直堆疊的N/P型電晶體的CFET架構。
技術節點的演進同時伴隨著材料的創新,例如在90nm節點引入的SiGe以誘發應變、在45nm節點時能大幅減小閘極漏電的HKMG,未來甚至可能引入二維材料,如MoS2、石墨烯等。當製程進入奈米尺度範疇,即使材料在化學成分組成上的微小差異,也會對電晶體特性產生重大影響。
結構分析方面,我們可以依賴具有高空間解析度的穿透式電子顯微鏡,但化學成分的分析,特別是分辨不同價態與鍵結,仍然是一項相當具挑戰性的工作。汎銓科技(MSSCORPS CO., LTD.)利用高解析度的穿透式電子顯微鏡搭配電子能量損失譜儀(EELS),開發出針對先進製程高解析化學成分分析的解決方案。
穿透式電子顯微鏡最常搭配的化學成份分析工具為能量色散X射線譜儀(Energy-dispersive X-ray spectrometer;EDS)。其工作原理是利用高能電子束激發樣品內層電子,透過檢測由此產生的特徵X射線進行成份分析。近年來隨著檢測器靈敏度和信號處理技術的持續提升,EDS已成為先進製程中不可或缺的化學分析技術。
然而,該技術仍然存在兩大弱點:一是定量分析精度局限,受元素原子序差異、電子躍遷概率變化及能量解析度…等因素,EDS只能提供定性或半定量特性分析資訊,無法實現精確的定量分析。其二是無法分辨不同價態與鍵結,由於特徵X射線的產生機制僅涉及原子內層電子躍遷,與物質的化學鍵結狀態無關,因此無法取得元素化學價態或分子結構資訊。這些技術弱點使得EDS在材料分析中常需與其他技術,如電子能量損失譜(Electron energy loss spectroscopy;EELS)互補使用,以獲取更全面的材料資訊。
電子能量損失譜(EELS)作為穿透式電子顯微鏡的進階分析技術,其原理在於解析入射電子穿透樣品時因非彈性散射產生的能量損失特徵,當高能量電子與原子相互作用時,其能量損失分佈,特別在元素游離能EC+50 eV範圍內的能量損失近邊精細結構(Energy loss near edge structure;ELNES),可精確反應元素的化學鍵結狀態與局域電子結構。
相較於EDS,EELS有兩大優勢:一是原子級的空間解析能力,結合球面像差校正的穿透式電子顯微鏡,EELS可實現次奈米的空間解析度,較EDS提升兩個數量級,二是具有化學價態的解析度,能量解析度可以達到100meV以下,因此EELS成為研究二維奈米材料及半導體缺陷研究的利器,其獨特的化學敏感度更填補了EDS在價態分析領域的技術空白,同時也比X射線光電子能譜(X-ray photo spectroscopy;XPS)分析更具有微區分析能力。
此次分析的主角是128GB的NAND快閃記憶體(圖1a),此NAND快閃記憶體是由市場上購買的iPhone 15 Pro所拆解下來的,因為快閃記憶體內部具有多層膜結構所構成的垂直通道(圖1b)。圖2為垂直通道的高倍穿透式電子顯微鏡的照片,其內部結構是由數層只有數奈米厚度的薄膜所組成,且矽(Si)、氮(N)與氧(O)有不同的化學鍵結狀態,因此是展示EELS分析最佳的目標。
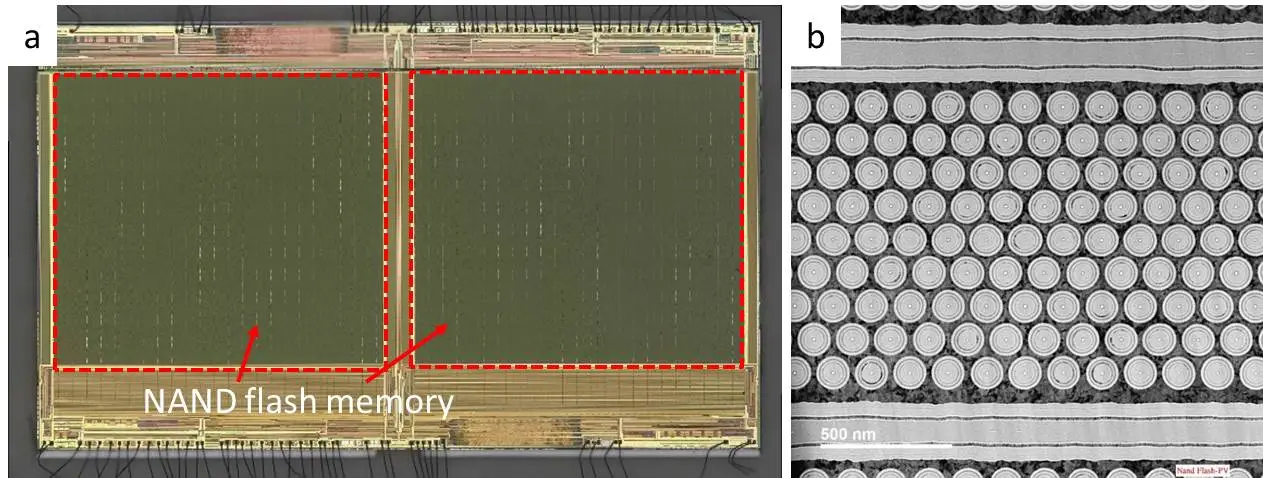
圖1:(a) 128 GB NAND快閃記憶體光學顯微鏡照片;(b)垂直通道的平面穿透式顯微鏡照片。
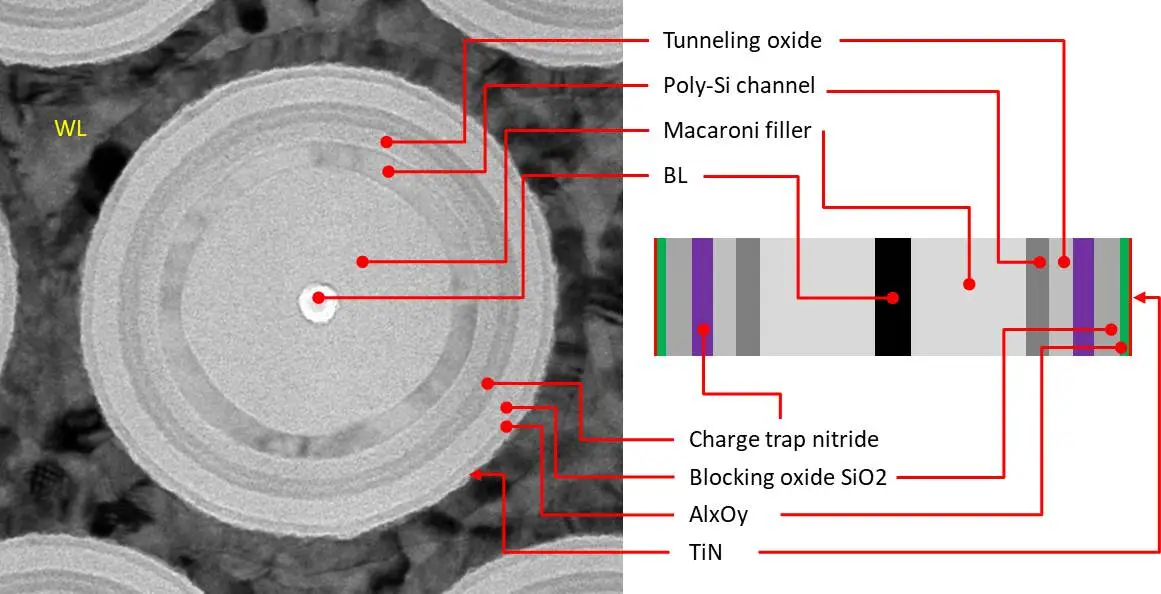
圖2:左邊為垂直通道的平面穿透式顯微鏡照片,右邊為標示垂直通道各層結構的卡通圖。

圖3前兩行照片是我們利用EELS分析通道的化學組成的結果,共有Al、Ti、W、Si、O與N六種元素,因為我們此次分析的重點是以Si、N與O為主,因此將Si、O與N的EDS分析結果呈現在圖3的第三行與EELS結果直接做比較,其中Si與O的結果很類似,但EELS在分析N訊號時呈現出更多的細微結構,
在通道的最外圈(也就是圖2所顯示的TiN)與WL相鄰處有出現明顯的N訊號,我們將EELS線圖譜與穿透式電子顯微鏡相疊(圖4),更能清楚看到N(綠色)與Ti(紫色)訊號在通道最外層都有一起起來的趨勢,這在EDS結果中並未發現,這很可能是因為偵測機制與TiN的厚度太薄使得EDS偵測到N訊號量不足所導致的結果,這也顯示出EELS在這部分的優勢。
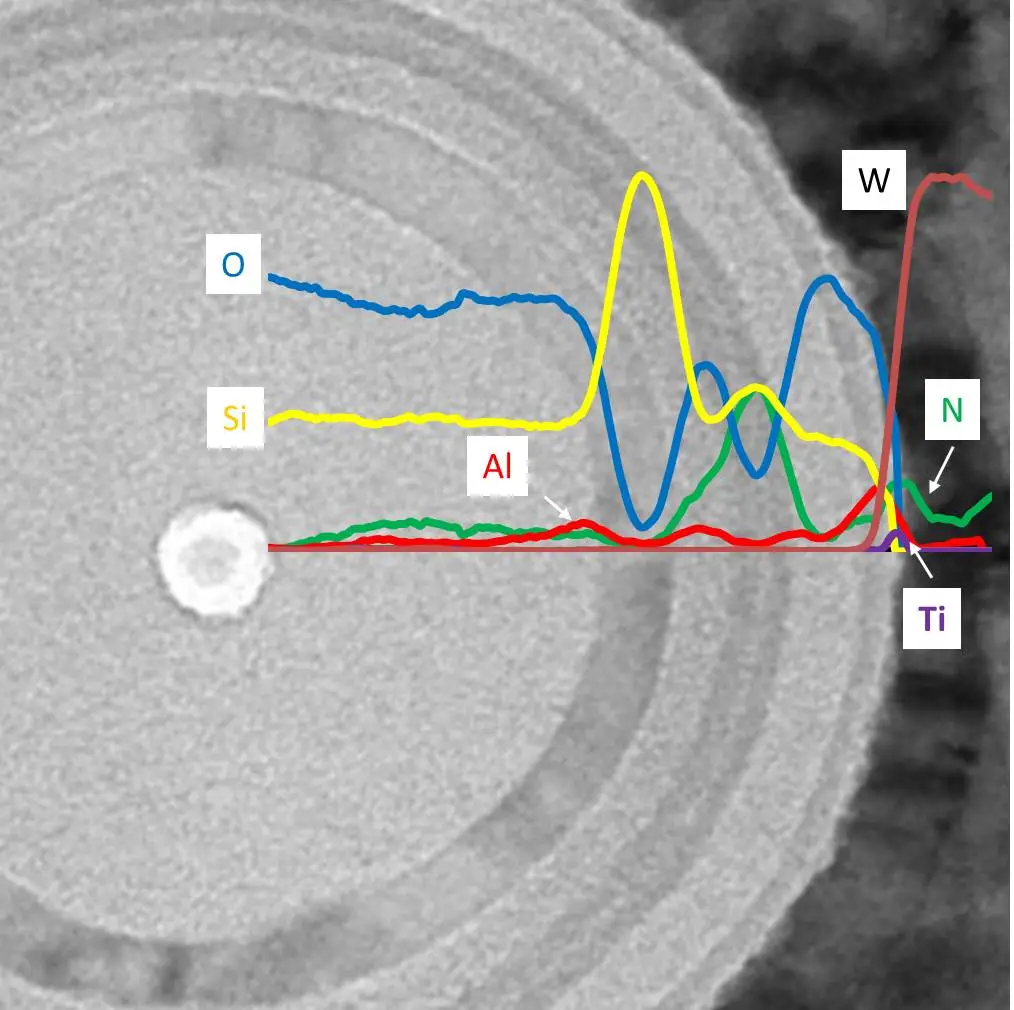
圖3:前兩行為垂直通道的EELS mapping,第三行為Si、O、N三元素的EDS mapping。
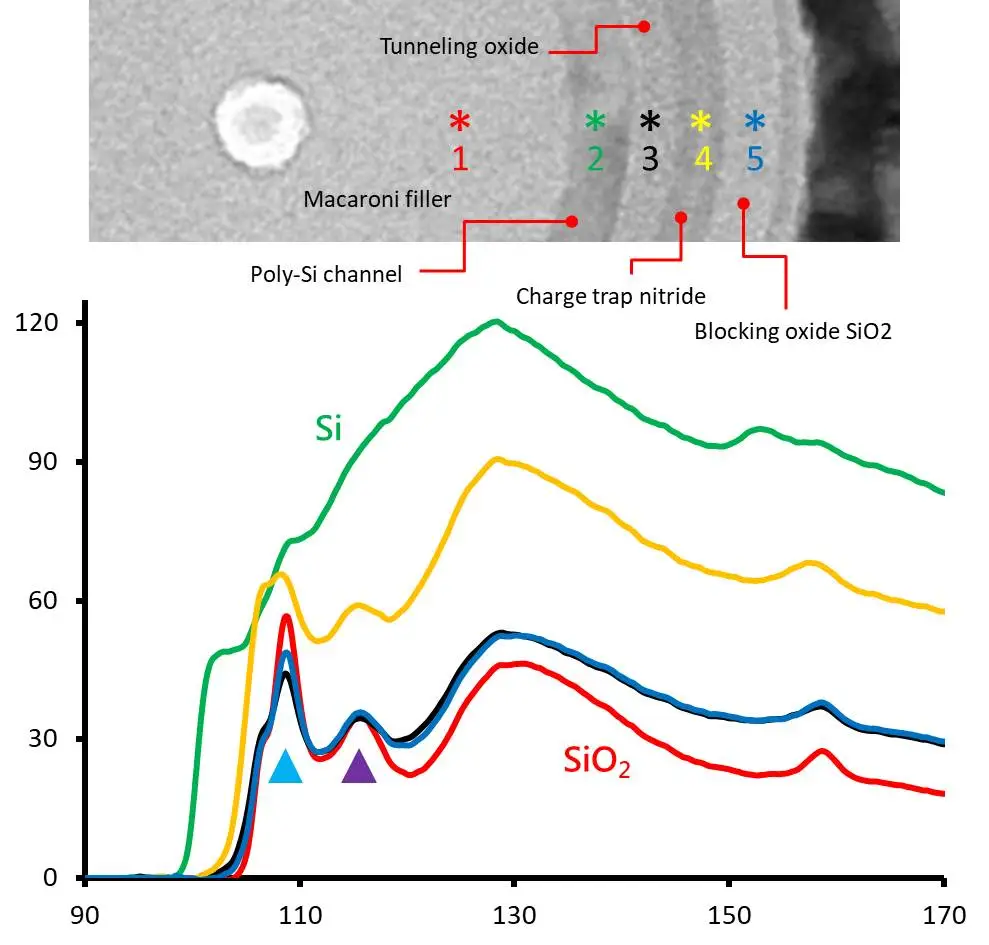
圖4:EELS譜線與垂直通道的平面穿透式顯微鏡照片疊加。
另外,由圖2可以得知,通道最外兩層的結構分別為AlxOy與TiN, 其Al與Ti的ELNES區間分別大約在73 (L2,3)與456 eV (L3),與Si-O、Si-N鍵結的ELNES區間有一段差距,考量到EELS的能量解析度,本文並未探討在這兩個能量區間相關元素的價態。
EELS最強大的功能是可以解析材料的化學鍵結,圖5是我們利用EELS分別在通道五個不同位置(以星號標示)所取得在ELNES的精細結構譜線,ELNES起始點(Threshold)代表此元素的鍵結能,我們將這五個位置所獲得的鍵結能整理在表1中,而ELNES區內譜線強度的變化反應元素的化學鍵結型態,每一種化態都有如指紋般地對應到唯一的精細結構譜線,只要待測位置的化學組成有些許改變,就能輕易地由精細結構譜線辨別出差異。

圖5:ELNES的精細結構譜線,五個分析位置標示於上圖。表1 :ELNES的精細結構譜線分析位置與鍵結能。
圖5中的位置1與位置2的Si的價態分別為+4與+0 (中性),因此確認為單純的二氧化矽(SiO2)與Si,可以當成參考與其它譜線做比較。3D NAND的製程中最常被討論也最重要的議題是電荷阱氮化物(Charge trap nitride),它與鄰近的穿隧氧化層與阻障氧化層-SiO2構成所謂的ONO結構,電荷阱氮化物取代了原本摻雜多晶矽負責儲存電子的工作,實現了在製造經濟上更有競爭力的好處。
位置4為電荷阱氮化物,也就是Si3N4,但與先前所發表論文的Si3N4精細結構譜線比較,發現位置4的譜線在115.4 eV有多一個能峰,這一個能峰位置剛好與SiO2其中一個能峰位置(以紫色三角形標示)幾乎相同,因此位置4的化學組成很可能不是只有單純的Si3N4,而是有加入了微量SiO2的Si3N4,由通道的架構來看我們所獲得的EELS結果並不全然沒有道理,因為電荷阱氮化物兩側分別為穿隧氧化層與阻障氧化層-SiO2,製程中兩側的 SiO2都很可能會擴散到電荷阱氮化物造成我們所看到的結果,至於在電荷阱氮化物中的SiO2如何分佈仍需要進一步探討,例如使用更高倍率的穿透式電子顯微鏡來確認電荷阱氮化物這一層的微結構。
位置3與位置5分別為穿隧氧化層與阻障氧化層-SiO2的精細結構譜線,其譜線型態與能峰位置與位置1 (純SiO2)非常相似,但深究後發現有兩處不同,第一是兩點的鍵結能由104.7eV往低能量分別移動0.7與0.5eV,也就是往位置4的電荷阱氮化物(103.2eV) 靠近,第二是在108.64eV的能峰(以天空色三角形標示)強度分別只有位置1的75 %與85 %,這顯示穿隧氧化層與阻障氧化層-SiO2都不單純只有SiO2這一相,由相鄰的結構與其精細結構譜線來推論,穿隧氧化層與阻障氧化層-SiO2很可能在SiO2中還含有不同微量的Si3N4。
我們以圖5的精細結構譜線分析Si (0+)、SiO2 (4+)以及Si3N4 (4+)為基礎,將不同價態與鍵結的Si在空間中的分佈獨立呈現於圖6左邊的小圖,這比圖3中EELS與EDS單純只呈現Si元素的分佈提供了更有價值的資訊。為了方便辨認,圖6也呈現AlxOy中Al的訊號,圖6右邊大圖則是將左手邊四張小圖疊加起來的結果。

圖6:左邊的小圖為ELNES phase mapping,右邊是將左邊小圖疊加再一起的結果。 基於上述NAND快閃記憶體通道的分析,我們可以清楚知道EELS是分析微小尺寸中元素不同價態與鍵結的利器,這對於製程尺寸越來越小且材料複雜度高的電晶體架構與先進封裝的材料分析帶來希望。





