矽光子 測試&光損斷點定位分析
矽光子測試: 測試矽光子PIC元件的光學特性(光損,偏振),應用於晶圓晶片, CPO 封裝,封裝模組到光纖元件之間介面,確認光路特性於能否符合設計製造規格, 篩選出PASS/FAIL的Chip & 封裝元件,以供出貨確認以及良率提升改善。
矽光子光損斷點定位分析(光導defect測試): 矽光子製程defect導致光導傳輸速率降低,甚至斷線時,精準判斷異常位置.在矽光子技術中,光導斷線(optical waveguide discontinuity)是一個常見的問題,會導致光信號的傳輸損耗甚至中斷。判斷光導是否斷線是確保矽光子電路性能的關鍵。以下是光導斷線的判斷方法及相關資訊:光導斷線是指光波導中結構的中斷或異常,導致光信號無法有效傳輸。這可能由以下原因造成:
- • 製造缺陷: 如光波導製程中的 Etch、Photo Warpage 或沉積缺陷。
- • 結構損壞: 由於熱應力、機械應力或操作不當導致波導損壞。
- • 設計問題: 光波導的幾何結構設計不合理(如急劇彎曲或錯誤的連接)。
- • 材料問題: 材料內部的吸收或散射特性劣化。
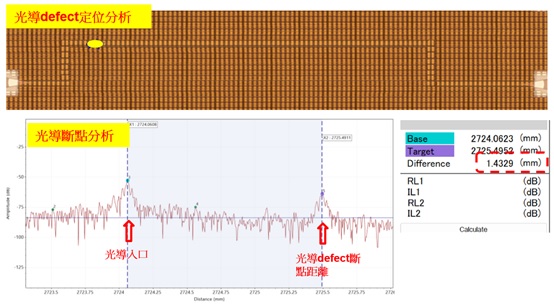
– 光導斷線的判斷方法
- 1. 光學測試方法
- • A.光學功率測試。
- • B.光學反射測試。
- • C.損耗測試。
- 2. 顯微與成像檢測
- • A.光學顯微鏡檢測。
- • B.掃描電子顯微鏡。
- • C.紅外熱成像。
- 3. 模擬與電測方法
- • A.模擬光場分佈。
- • B.電學測試。
– 光耦合器Insertion Loss Test & PIC進程
光導插入損耗(Insertion Loss, IL)測試 是評估光波導及光子器件中,光信號損耗的重要方法之一。插入損耗定義為光信號在通過波導或器件時所經歷的功率損耗。這種測試廣泛應用於矽光子器件、光纖系統和光學模組中。
損耗的因素
耦合效率,吸收損耗,製程缺陷,彎曲損耗,反射損耗。
矽光子積體光路(PIC, Photonic Integrated Circuit)是一種將多個光學功能元件集合在單一晶片上的技術,用於實現高速通信、光學傳感、AI運算和其他先進應用。從設計到測試與驗證,PIC 的開發流程可以分為幾個關鍵階段:設計、製造、封裝與測試。