EETIMES 刊登 汎銓科技技術文章 「為3nm GAA電晶體實現電性測量」
![]() 2024.12.18
2024.12.18
 新聞公告
新聞公告
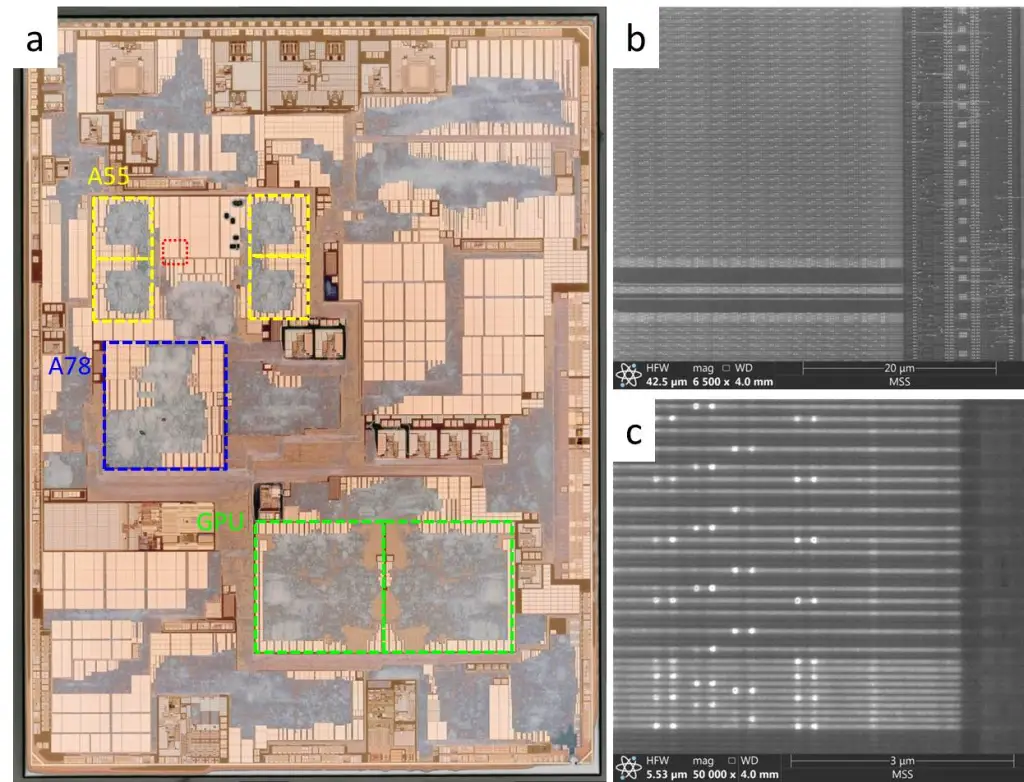
為了實現3nm GAA電晶體測量,汎銓科技以Samsung Galaxy Watch 7應用處理器Exynos W1000進行分析,協助製程工程師深入了解電晶體的電性特徵...
先進半導體晶片的製造是一個高度複雜且精密的過程,涉及一系列多達上千道的製程步驟,這些步驟包含了黃光、蝕刻、擴散、薄膜和化學機械研磨等工序,隨著製程技術的不斷進步,當前最新的製程節點已經來到3nm,這對製程的精準度和良率提出了更高的要求,任何一道工序的微小誤差都可能導致最終晶片的良率接近於零,因此,半導體廠必須對每一個製程的品質進行嚴格的監控,檢測在這一過程中顯得尤為重要。
檢測不僅僅是量測,它還包括量測數據後的深入解析,提供進一步提升良率的重要依據,尤其是在進入3nm製程節點之後,以尺寸的量測為例,其精準度要求達已到了奈米甚至埃米(Angstrom)的範圍,在這樣的精度要求下,檢測工具和分析技術的發展成為了提升良率的關鍵。
以對單一電晶體進行電性量測為例,使用奈米探針(Nanoprober)進行操作,奈米探針必須精確且穩固地接觸到電晶體的M0下方的VG/VD部位,這些VG/VD的尺寸約在15-30nm的範圍內,為了不碰觸到旁邊其它VG/VD造成短路,奈米探針的針尖必須小於VG/VD的尺寸,且在一般的電晶體電流/電壓(IV)量測中,通常需要四根奈米探針來分別接觸閘極、汲極、源極和基板,且這些電極的VG/VD的空間只坐落在約100X50nm2的面積內,因此對於定位精準度的要求極高。
除了定位的精準度,奈米探針與VG/VD之間的接觸力道也是影響量測品質的重要因素,接觸力道過小可能導致接觸電阻過高,進而影響量測的穩定性;而力道過大則可能損傷VG/VD,造成無法恢復的損壞,因此,無論是奈米探針的定位還是接觸,都需要依賴經驗豐富的工程師來完成這一複雜的量測任務。
然而,隨著電晶體架構即將進入GAAFET (全閘極環繞場效應電晶體)時代,這一轉變將為單一電晶體的電性量測帶來新的挑戰。GAAFET技術的核心在於其獨特的結構,即閘極環繞整個通道,這一革命性的設計可以讓閘極對通道有更好的控制能力、減少功耗以及有效提升電晶體的效能,但同時也對電性量測技術提出了更高的要求,在GAAFET結構中,量測的難度不僅在於元件的微小尺寸,還在於如何準確穩定地量測到其電性的特徵。
為了提供最新3nm GAA電晶體量測的解決方案,汎銓科技(Msscorps)選擇Samsung Galaxy Watch 7的應用處理器Exynos W1000作為分析對象。Exynos W1000採用Samsung 3nm MBCFET製程節點,MBC為Multi bridge channel的縮寫,就是閘極環繞整個通道的架構,也就是GAA架構,新的架構提升了電晶體的整體性能。
本文分成兩大部份,分別為試片製備與電晶體電性的量測。首先第一步需要對試片進行精細的製備,晶片的平整度將是量測是否成功的關鍵,接著,透過奈米探針精密的位置移動平台,將奈米探針精確地定位於電晶體的VG/VD上,並施以適當接觸力,確保量測的準確性,具體的量測流程包括IV曲線的獲取、參數的分析與比較等,透過這些數據,製程工程師可以深入了解電晶體的電性特徵。
為了確保試片製備的精準性,了解晶片製程是至關重要的第一步,圖1a展示了Exynos W1000的截面掃描電子顯微鏡照片,其中後段製程(BEOL)包含15層金屬層,圖1b則為圖1a在M12以下的局部放大圖,從中可以明顯看出,越靠近底層的金屬層,尤其是M4到M1的厚度逐漸變薄,而在M1以下的結構則需利用解析度更高的穿透式電子顯微鏡進行觀察,圖1c為高解析度的穿透式電子顯微鏡照片,顯示M1以下還有M0、VG/VD及金屬接觸(Metal contact)的存在,實務上就是使用奈米探針接觸VG/VD以進行電性量測,因此量測前,首先需要將試片處理到VG/VD,且為了讓奈米探針能有穩固的接觸,VG/VD最好能製備到高出旁邊的介電層約3-5nm,因此,製備工程師必須具備高超的技術與豐富的經驗,以完成這項精確度高的挑戰。
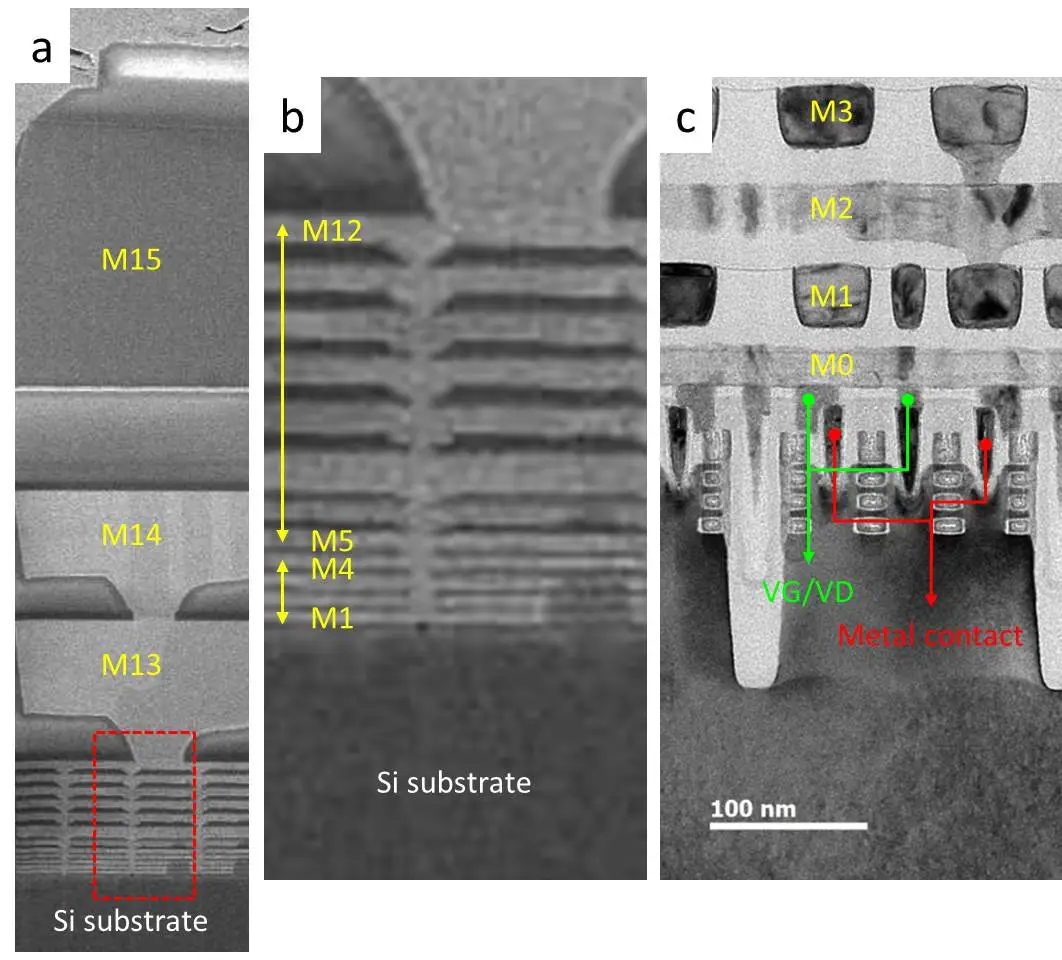
圖1:(a) Exynos W1000的截面掃描電子顯微鏡照片;(b)圖a中紅色虛線方框的放大照片;(c) M3以下的穿透式電子顯微鏡照片,VG/VD與金屬接觸位置分別以綠色和紅色圓點標示。
試片處理分為兩個階段,第一階段採用人工平行研磨(Manual parallel lapping)技術,將試片從M15逐步去層至V4,圖2a顯示了Exynos W1000去層至V4的光學顯微鏡照片,從晶片的整體均勻顏色可見,人工平行去層的平整度相當優異,本文此次分析的重點是位於兩個Arm Cortex-A55核心中紅色虛線方框所標示的6T-SRAM區域,圖2b展示這一目標區的掃描電子顯微鏡照片,圖2c則是圖2b的放大照片,亮點標示了Via的位置。考慮到V4以下的金屬層厚度僅有23-46nm,為了提高去層的準確性,因此在V4以下的處理將由能夠提供更高精準度的電漿聚焦離子束(Plasma focus ion beam;PFIB)接手,將試片進一步處理至VG/VD,該去層過程利用鈍氣電漿和特殊氣體輔助,實現了局部精確去層。
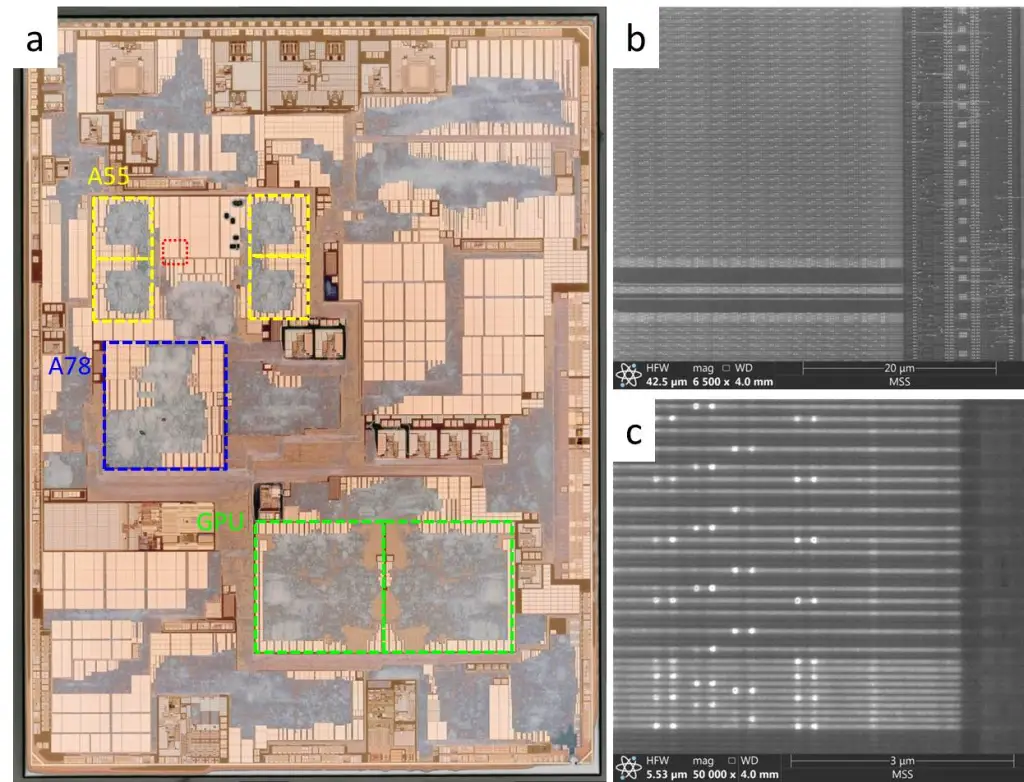
圖2:(a) Exynos W1000在人工平行研磨至V4的光學顯微鏡照片,Arm Cortex-A78、Arm Cortex-A55與Arm Mali-G68 GPU分別以藍色、黃色以及綠色虛線方框標示,紅色虛線方框為本次分析位置;(b)分析位置的掃描電子顯微鏡照片;(c)圖b的放大圖。
圖3展示了在電漿聚焦離子束去層過程中每一層的掃描電子顯微鏡照片,並未發現層差現象,顯示出去層的高穩定性。圖4a是試片製備完成後的掃描電子顯微鏡照片,可明顯觀察到電漿聚焦離子束的去層範圍,圖4b為圖4a在去層邊緣的局部放大圖,清楚展示了M4到VG/VD各層的落差。
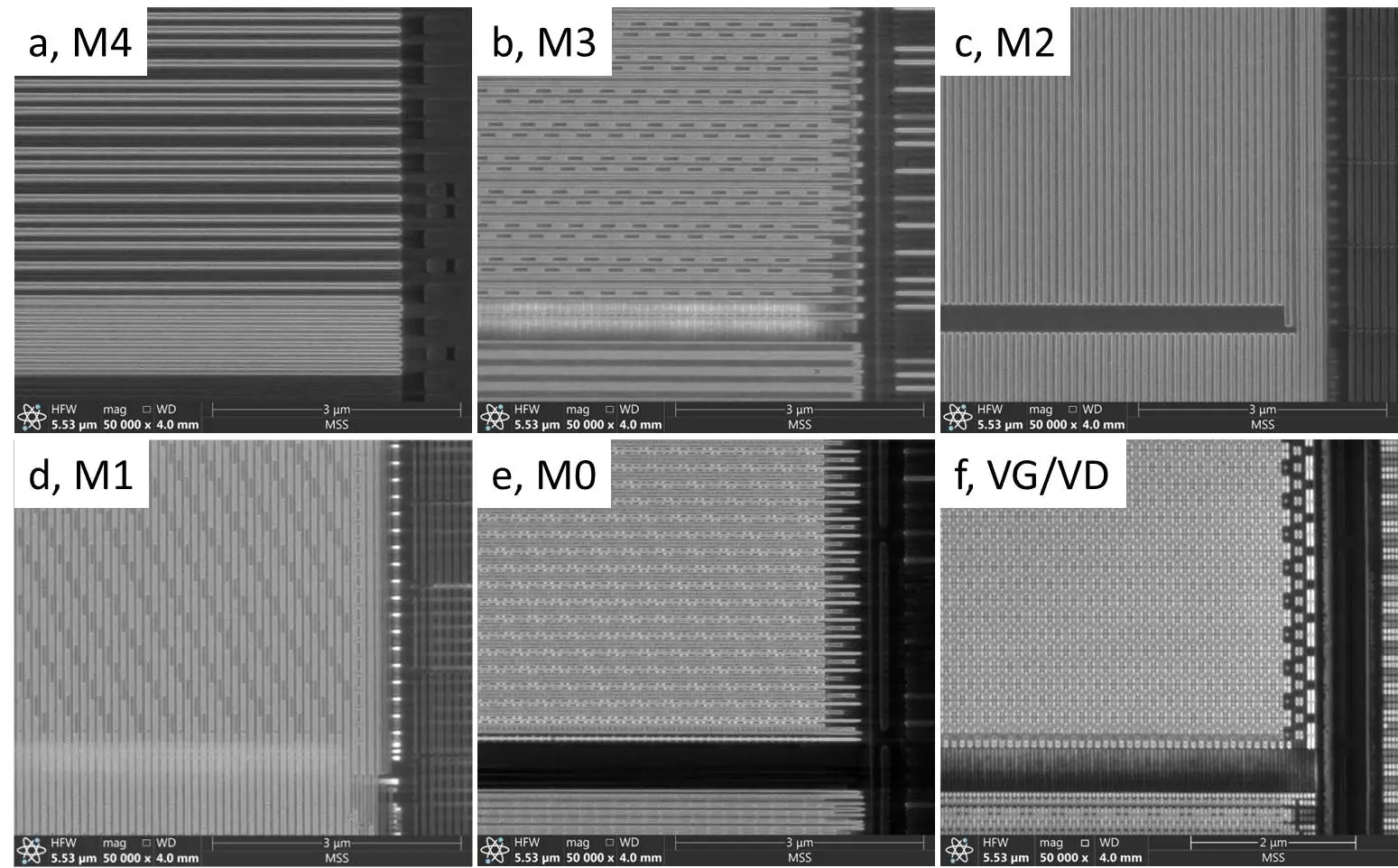
圖3:Exynos W1000以電漿聚焦離子束去層處理至M4、M3、M2、M1、M0以及VG/VD的掃描電子顯微鏡照片。
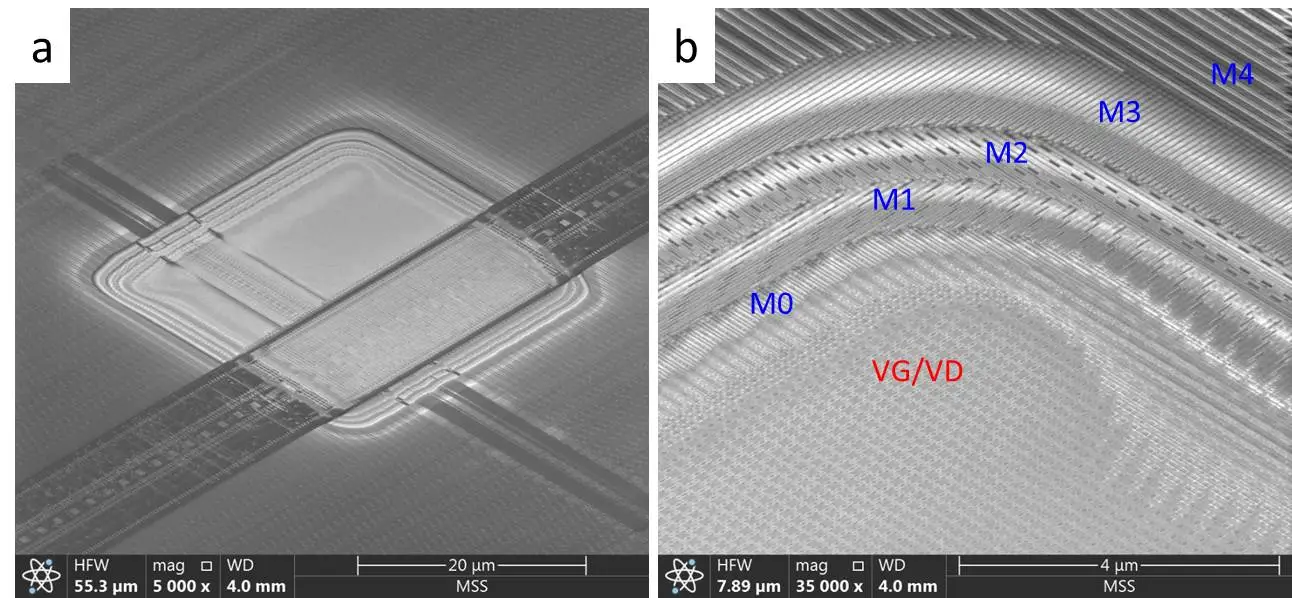
圖4:(a) Exynos W1000完成電漿聚焦離子束去層處理後的掃描電子顯微鏡照片;(b)圖a其中一角落的放大圖。
電晶體的電性量測過程中,本文採用Nanoprober量測工法,這項工法是利用數根針尖直徑僅有10-20奈米的金屬探針,經由精確的控制,逐一接觸目標電晶體的VG/VD,此工法的關鍵在於金屬探針與VG/VD接觸的力道,因為接觸力道過大或過小都可能對量測結果造成顯著影響,因此,操作工程師的技術與經驗在此過程中扮演著至關重要的角色,圖5展示了使用Nanoprober對6T-SRAM中PD (NMOS)電晶體進行的電性量測結果,透過左上方的掃描電子顯微鏡照片可清楚觀察到奈米探針與VG/VD的接觸狀況,並且從平滑的電性曲線可得知奈米探針與VG/VD之間的接觸是相當穩定的。
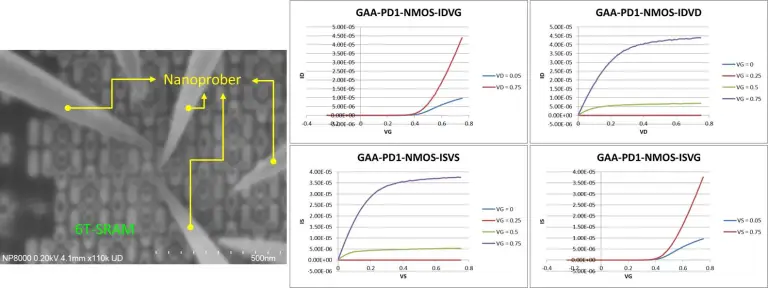
圖5:左上角為Nanoprober在PD電晶體量測的掃描電子顯微鏡照片,其餘為在PD電晶體量測的電性曲線圖。
GAAFET作為一種新興的電晶體架構,提供了更佳的效能與更低的功耗優勢,然而,實現這些優勢的前提是必須克服其在測量方面的挑戰,由上述的說明可以清楚了解到GAAFET在電性量測上的挑戰主要來自於需要高穩定且精準的試片製備能力與能精密控制位置/力道的奈米探針。隨著電晶體尺寸持續微縮,架構不斷演進,未來電晶體的分析與量測將面臨更巨大的困難與挑戰,汎銓科技將持續研發新的分析手法與技術,領航半導體高階製程。





