晶片壽命試驗
晶片壽命試驗,是半導體產品可靠度試驗中最重要的一環,也相對較難以Family概念省去試驗的項目。晶片產品種類複雜,因此在初期評估過程考量的點也多,以避免實驗過程耗時耗工。汎銓科技可靠度實驗室網羅業界經驗豐富專業人士加入,並提供單一窗口整合服務機制,客戶可透過單一窗口,進行試驗規劃與評估,並以最合理價格與最佳交期,加速試驗完成。
– 硬件評估與製作
硬件設計是晶片壽命前期最重要的準備工作之一,硬件設計考量使用的電流、電壓、電源組數與配置、高頻材料、硬件用料、特性阻抗、疊構設計、程式向量等,需要透過具有專業經驗人員的協助進行。汎銓科技考量客戶驗證成本,準備多種公板,使客戶可以減少製作專板的成本。此外與國內外多家優良硬件設計公司合作,確保硬件使用壽命。
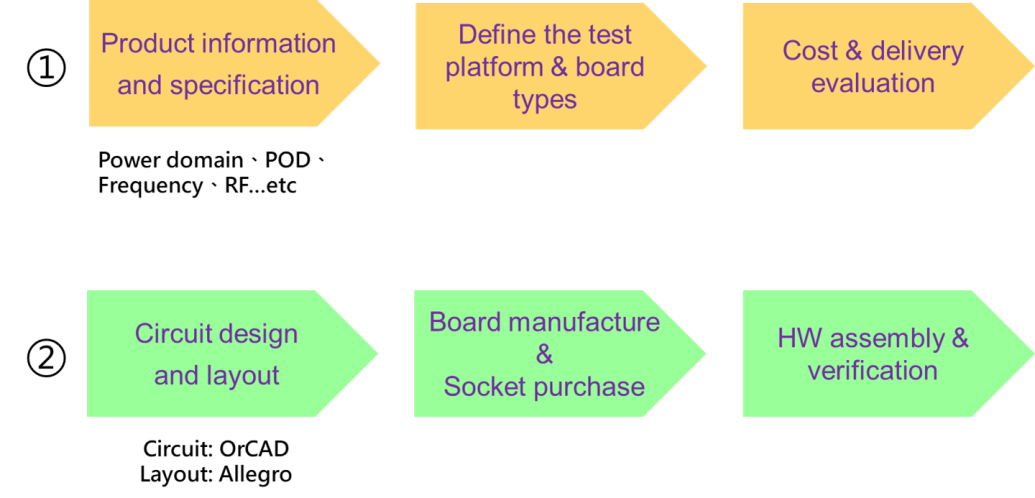
– 晶片壽命試驗項目
晶片壽命試驗因晶片種類,區分多項類別,試驗手法差異大,在初期評估過程已經決定方案。執行壽命試驗前,得進行前期驗證,確認晶片輸出正常或硬件配置無問題等。汎銓科技目前可服務的晶片壽命試驗項目如下:
- • 高溫/低溫壽命試驗 (HTOL/LTOL),對晶片產品除了提供電源外,並提供測試程式實際執行晶片運作模擬,並透過設備電腦監控電流變化並記錄。
- • 偏壓壽命試驗 (Bias Life Test),屬於較容易執行的壽命試驗類,透過高溫或低溫環境並提供電源,進行老化模擬,過程監控電流變化並記錄。
- • 非揮發性記憶體讀寫與保持力壽命試驗 (NVM EDR):針對NVM所作的特殊驗證項目,由於NVM可儲存資料功能,因此資料的保持力或者重複擦寫,必須獲得穩定控制,實際試驗包括高溫與低溫,模擬不同環境下資料持久性。
- • Driver IC MIPI System,針對Driver IC壽命試驗中重要的一環,透過MIPI訊號設定以及電源等模式,簡化試驗過程,提高正確性並創造規模經濟縮短產品的上市時間。
- • 早夭壽命試驗 (ELFR):早夭壽命試驗屬於放大量驗證的一環,數量增加但縮短時間進行產品篩選。早夭壽命試驗對於產品壽命預估較為準確,且可避免產品出貨使用後半年內的風險不良等,對高階產品或車用電子尤其重要。
- • 離散元件(Discrete Semiconductor)壽命試驗,與晶片測試差異大,壽命試驗根據離散元件種類,選擇適當測試項目,常見的有HTGB、HTRB、IOL、PTC、H3TRB等項目較為常見。
– 晶片壽命試驗設備
- • 美國MCC LC2系列中高瓦數burn in系統,可提供獨立溫控(ICTC)與非獨立溫控以及低溫LTOL,電源組數10組,可供應單顆50W晶片進行實驗。
- • 韓國DI DL601H系列中低瓦數burn in系統,屬於非獨立溫控設備,電源組數8組,可供應單顆最高20W晶片進行實驗。
- • ESPEC Oven、超高溫度穩定性與熱負載能力、搭配Keysignt電源供應器使用。
- • MIPI訊號系統,支持五通道MIPI DSI Dual D-PHY (8Lane) 或Single (4Lane)複製支援每個通道4 Gbps / 4lane,最高解析2560 x 1600。
- • 公板/萬用板,僅設計製造socket card,可協助客戶cost down硬件費用。




▍技術窗口
RA:陳先生
+886-3-6663298 ext. 3983 / 3984
yc_chen@msscorps.com




